GS-300 series
半導體量測設備 GS-300|晶圓厚度與線上膜厚量測
・簡單針對研磨機等量産製程進行整合。減少wafer汚染
・可對應半導体生產工程的高throughput的要求
・可針對wafer表面的pattern作對位alignment
・對應Notch aligment功能
・研磨後wafer厚度測定、可針對鍍膜後的wafer做面內膜厚管理
・二次工程研磨於chipping為防止破片的最佳對策。
・針對高端產品於wafer厚度的品質能有效提升。
・可對應半導体生產工程的高throughput的要求
・可針對wafer表面的pattern作對位alignment
・對應Notch aligment功能
・研磨後wafer厚度測定、可針對鍍膜後的wafer做面內膜厚管理
・二次工程研磨於chipping為防止破片的最佳對策。
・針對高端產品於wafer厚度的品質能有效提升。
量測項目
- 多層膜解析
- 光學常數nk值(n:折射率、k:消光係數)
産品資訊
晶圓厚度&線上膜厚量測設備產品特長 |
■GS-300為可針對Φ300mmEFEM裝置的預備port進行In-situ Metrology Unit的整合。
・簡單針對研磨機等量産製程進行整合。減少wafer汚染
・可對應半導体生產工程的高throughput的要求
・可針對wafer表面的pattern作對位alignment
・對應Notch aligment功能
・500x500mm小footprint
・用R-θ載物台移動方式來測繪測量資料。研磨後wafer厚度測定、可針對鍍膜後的wafer做面內膜厚管理
■GS-300、能有效生成研磨前後差異Mapping資料等、尤其在2次研磨中必要的資料作成
・能量測WAFER EDGE附近膜厚 ⇒可最適化定義WAFER有効區
在次工程研磨於chipping為防止破片的最佳對策
・化合物WAFER、貼合的評價 ⇒針對高端產品於wafer厚度的品質能有效提升
晶圓厚度&線上膜厚量測設備系統化構成 |
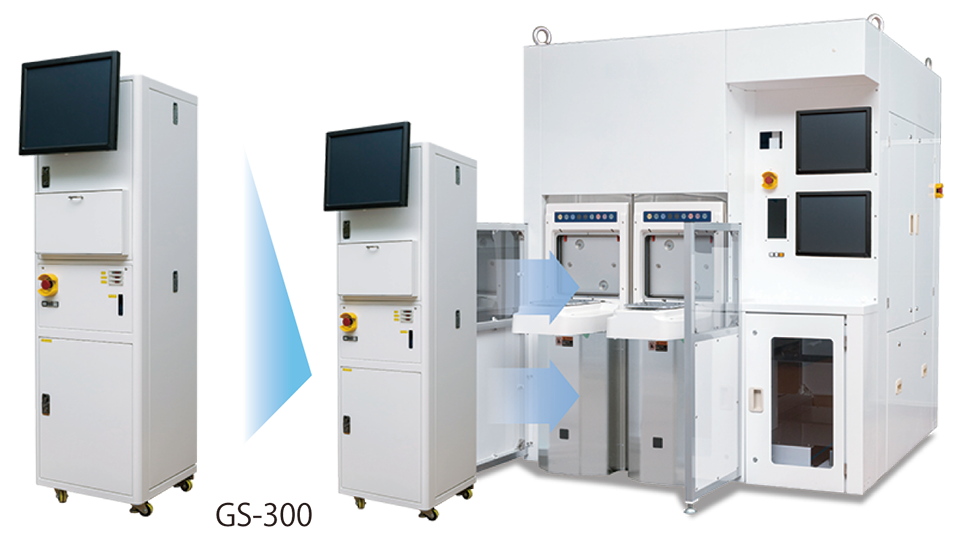
One through研磨處理

研磨 研磨結束・排出 GS-300的stage搬入 厚度量測開始 高速測定中表示
測定顯示例(研磨後WAFER厚度評価)

GS-300内部構造與流程
GS-300的処理(節省從製造設備到検査設備的搬送時間・以One through的構造降低WAFER的汚染.
(1)針對製造装置内如研磨等工程後的WAFER、為了以MAPPING的方式確認於同装置内的平坦度等而導入GS-300。
(2)將WAFER設置於GS-300内的R-θstage上。以6萬點約1分(最快的情況下)MAPPING量測。
(3)測定終了後、生成次工程必要資料型式後將WAFER從GS-300排出。
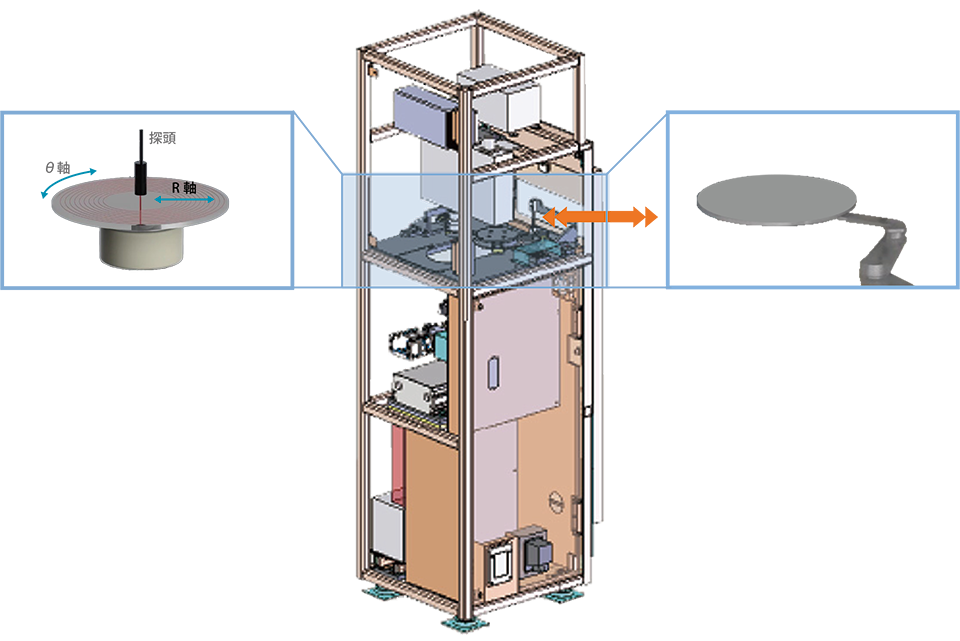
晶圓搬送進片方向可自由設置選擇(如有prealignment功能)、量産製程中容易整合(500 X 500mmのfootprint)
厚膜・粗糙面厚度量測原理與高速量測 |
將光照射於測定対象(基板)上後、會引起表面反射光與裏面反射光的交互干涉(多重反射)。
當光的位相一致時強度變強、不一致時變弱。觀測光譜因伴隨的波長的變化,反射強度而変化的干渉型式。
分光干渉法為解析這光譜進而求得厚度的手法。
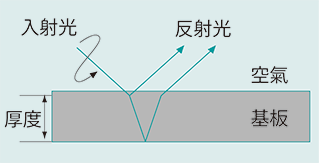 光干渉原理
光干渉原理膜厚解析(周波数解析法)
GS-300使用的膜厚解析為周波数解析法、以弊社考慮獨自屈折率n的波長分散性的解析技術、
於厚膜領域也能高精度解析出與實際值相當接近之膜厚。(已取得專利 第4834847号)
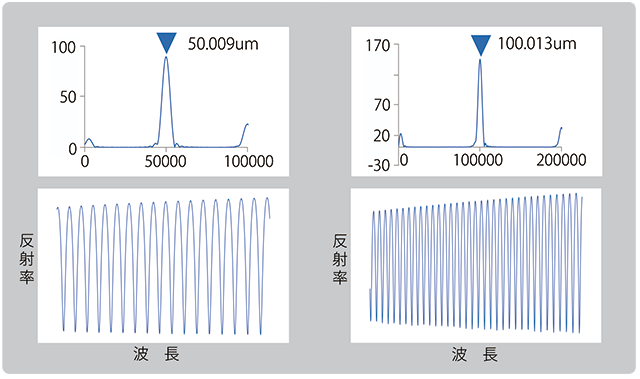
反射光譜→周波数解析法→並求出厚度的方法
對應高速量測
導入以一量測點約20um, 最快1msec.高性能感應器"SF-3"來針對移動的樣品, 以6萬點約1分(最快的情況下)MAPPING量測。
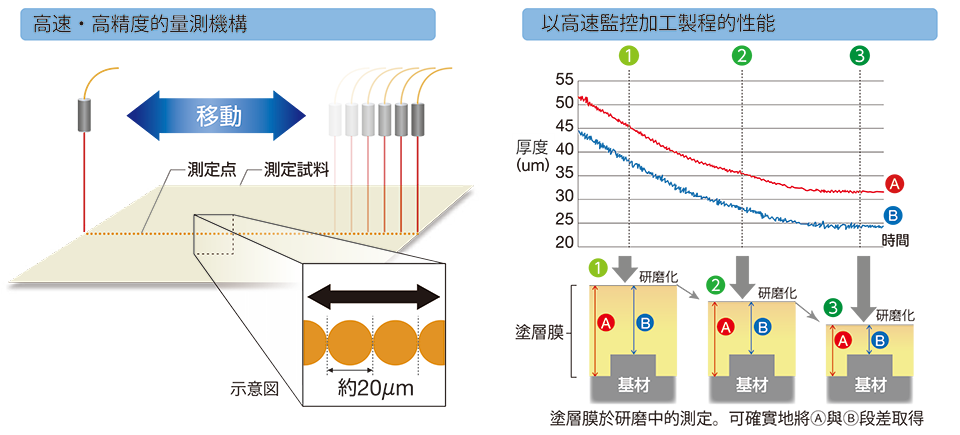
針對需求選擇檢出器Line up |

規格樣式
| 晶圓厚度&線上膜厚量測設備GS-300 series | |
| 樣本尺寸 | 最大300mm |
| 載物台方式 | R - θ自動載物台 |
| 修正晶圓角度・圖形校準 | 有 |
| 晶圓厚度範囲 | 基材(6um - 1300um) |
| 尺 寸 | W500×D500×H1680mm ※開關等突起部除外 ※H包括腳輪尺寸 ※H可用調節器調整高度 |
| 重 量 | 約120Kg ※端頭部除外 |
| 電 容 | AC200V±10% 4KVA |
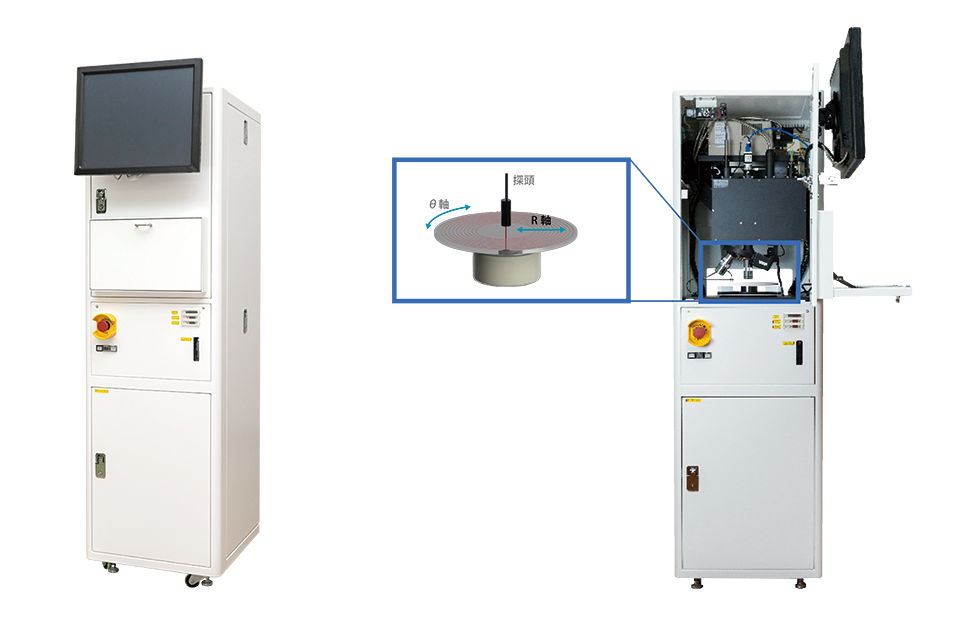
量測範例
| 測繪測量資料例(研磨後晶圓Si 層的厚度) |

| 測繪測量資料例(量測樹脂層厚度) |
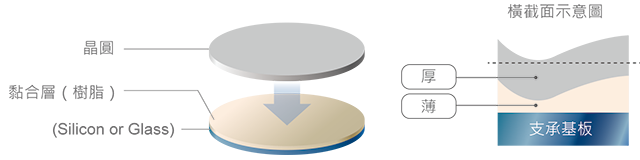
測量結果(黏合層的厚度分布 約6μm、研磨後Si晶圓層的厚度分布 約10μm)

technical article
技術文章
-
14Nov.2025
Wafer是什麼?前後2大半導體製程,帶你掌握晶圓的祕密!
許多人對於半導體產業不熟悉,尤其是對半導體製程的概念更是一知半解?!其實,主要是用來製作晶片的半導體製程,是需要透過一系列的專業步驟與搭配粒徑以及饃厚量測後,才能被完整的運用在各個產業之中。若你對於半導體製程還是有許多疑問的話,不妨就一起透過本篇專家的講解來了解吧!
Related Products