06Dec.2022
膜厚儀
CMP是什麼意思?Slurry製程深入介紹,清楚瞭解技術與原理!

CMP是什麼意思?製程中可應用在哪些環節?
所謂的「CMP」,意為「化學機械研磨,Chemical-Mechanical Polishing」的縮寫。是指使用研磨劑(Slurry),將晶圓減薄或是鏡面化的一道工藝。一般在半導體前段製程中,會使用化學腐蝕與機械加工的方式,歷經反覆地曝光顯影蝕刻所形成的微電路中。如果在每一道製程下,卻有表面平整度不均與凹凸不平的缺陷,將會影響最終成品的良率與效率。故CMP製程,則是讓反覆製程堆疊造成的高低誤差減少或是去除,讓製程中的晶圓基材或鍍膜材料表面厚度減薄的一種方式。
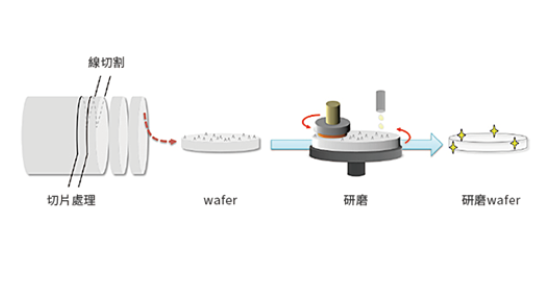
CMP製程中的應用環節
而在半導體製程日益精進的今日,從一開始的類比IC、記憶體到邏輯IC的產品推進中,每一世代從1.3毫米~3奈米的產品複雜度與日俱增,使用到CMP製程的頻率更甚以往。 在半導體反覆鍍膜後,利用CMP製程將多餘的厚度給移除後再鍍上另外一層;如同建造高樓大廈般,在每一層的堆疊中,CMP製程是用來精準控制每一層鍍膜高度的最佳監工。CMP製程除了厚度控制以外,最後進行的表面拋光也是CMP一道手續。將已經研磨至目標厚度的晶圓表面殘留物去除(也有人稱為鏡面加工),以亮晶晶的表面迎接下一道半導體製程。一般來說,CMP製程中會有下列環節:
| 將被研磨物放置貼合至於研磨底盤Pad |
⬇
| CMP研磨液注入 |
⬇
| 設置轉速、研磨時間、目標厚度... |
⬇
| 開始研磨拋光 |
⬇
| 研磨結束後清洗 |
CMP Slurry是什麼?作用與組成成分有哪些?
所謂的「CMP Slurry(化學機械研磨液)」,就是一種同時結合化學反應與機械磨耗作用於晶圓表面的核心材料。CMP Slurry主要功能在於先透過化學反應使材料表層產生氧化或軟化,接著藉由磨料的微切削作用達到平坦化效果,有效消除晶圓表面的高度差異。CMP Slurry性能是會直接影響晶圓的去除率、表面粗糙度、缺陷密度,進而影響後續製程的良率表現。一般而言,CMP Slurry主要由以下幾種成分組成:磨料、化學反應物、界面調整劑與pH控制系統。這些成分之間的搭配與平衡關係,將直接決定研磨行為的穩定性與效率。CMP Slurry的設計在於建立「化學軟化 × 機械研磨」的最佳平衡,使其於不同膜種中皆能提供穩定且可預測的研磨表現。CMP Slurry 的3大組成與作用機制如下:
✅磨料(Abrasive)
常見材質包括:SiO₂、Al₂O₃、CeO₂ 等。磨料粒徑大小、粒度分佈(PSD)、表面電位以及形貌會影響去除率與缺陷形成。舉例來說,粒徑過大可能提高刮痕風險,而粒徑分布過寬則容易造成非預期的局部侵蝕。✅化學反應物與添加劑(Oxidizers / Complexing Agents / Corrosion Inhibitors)
化學反應物負責控制材料的氧化速率,並搭配螯合劑、緩蝕劑等添加物,形成特定膜種的選擇性,例如:銅CMP Slurry中會加入緩蝕劑抑制過度腐蝕,使去除行為更可控。✅pH控制與分散穩定機制(pH Adjusters / Dispersants / Stabilizers)
pH不僅會影響化學反應速率,也會左右磨料表面電荷,使得Slurry的分散狀態更加穩定。並適當的穩定機制能避免粒子聚集、沉降與凝聚造成的異常缺陷。CMP製程技術與原理介紹
在CMP製程中,能否精準地將多餘厚度移除,主要是取決於幾種重要的零部件;研磨頭Disk、研磨墊底盤Pad與研磨液Slurry,皆會影響研磨製程好壞的重要因素。在良好的CMP製程中,CMP研磨頭Disk的研磨顆粒細緻度,會直接影響研磨後待測物表面的平整度(粗糙度Ra);研磨墊底盤Pad與樣品的黏貼均一性,也會影響整個樣品研磨後的上下表面是否為水平狀。
而CMP研磨液Slurry,更是CMP研磨中不可或缺的潤滑劑與散熱材。可根據不同的研磨目標,選用不同種類的研磨液,例如:不同粒徑大小、不同種類粒子、不同組成溶液等等。
| 關鍵因素 | 影響 | |
|---|---|---|
| CMP研磨頭Disk | 研磨頭細緻度 | 研磨後的平整度(粗糙度Ra) |
| CMP研磨墊Pad | 黏貼均一性 | 研磨樣品的水平 |
| CMP研磨液Slurry | 粒徑大小、電位正負與晶圓的關係 | 研磨效果 |
| CMP清潔液Cleaner | 電位正負與晶圓的關係 | 清潔效果 |
在研磨的產品中,又有分單面拋光與雙面拋光:
- 單面拋光:指在上面加以一平均分散的機械力於單一方向的旋轉後,使待測物表面以固定速率來移除表面的厚度
- 雙面拋光:是指待測物的正面&反面各施予反方向的旋轉的機械力來研磨,並依據實際產品的需要,而使用各自符合的方式來達成其減薄目的
CMP製程如何應用在環節中?
👉 CMP製程關鍵材料|研磨液的粒徑與界達電位

講到CMP製程中不可或缺的就是-CMP研磨液,品質不佳的研磨液可能會讓晶圓表面直接變身月球表面。根據不同研磨程度,選用不同大小及種類的研磨液。大塚的ELSZ系列為業界普遍採用的界達電位粒徑分析機種,具有強大的感度以及穩定性幫您監控研磨液的穩定度。
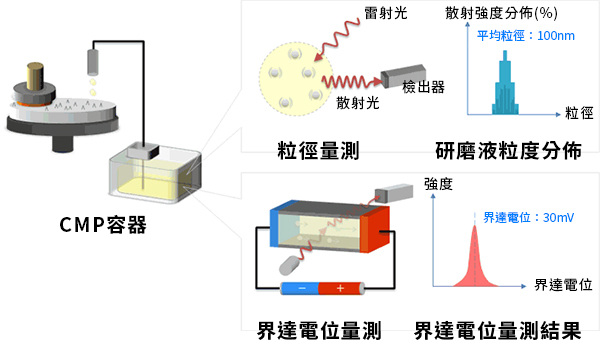
👉 CMP製程關鍵研究|晶圓表面電位與研磨液及清潔劑的交互作用
除了研磨液以外,被研磨的對象晶圓本身表面電位也是一個重要的參數。為了控制晶圓與研磨液的關係,表面電位也是一個重要指標。大塚獨家的固體表面電位量測,可直接量測晶圓的表面電位,更可以自由更換液相成份讓你得到晶圓<=>研磨液,或晶圓<=>清潔劑的交互作用。且除了晶圓本身以外,也可研究研磨底盤Pad的電位喔!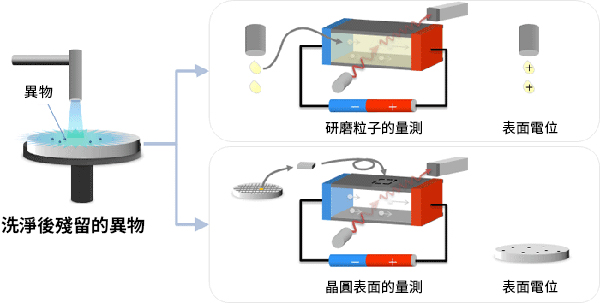
👍推薦閱讀: 界達電位量測原理介紹,固態樣品表面電位(surface zeta potential)量測方法與實踐-->
👉 CMP製程即時監控|架設於研磨機內部即時監控研磨厚度

針對於半導體基材不管是Si、GaAs、GaN、SiC等,皆可使用CMP方式使其材表面平坦化。大塚使用其獨自開發的光學膜厚量測技術,可針對上述所提到的各種半導體基材做即時研磨監控與厚度管理。
特別是SF-3晶圓即時量測單元,利用強度穩定之半導體雷射於正面量測反射率,可直接內藏於各種製程設備中,並針對基材厚度做real time的基材厚度量測。可輕鬆得到應用高速研磨的CMP設備中,單點量測的時間低最低可以達到μs等級。
不只是單層基材構造可以對應,針對半導體於3D IC封裝時其晶背減薄厚,也能夠輕易地將上層Si減薄層的厚度量出。量測精度方面,更是超越目前市面上其他量測方式的結果。另外,還可搭配小光斑20um的量測點位,可透過CCD對位的方式,針對樣品表面特定之Pattern量測定點厚度量測。
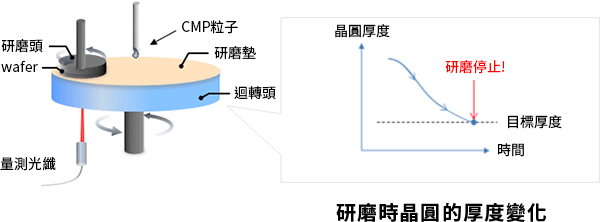
👉 CMP製程成果發表|研磨後膜厚分佈量測

針對薄膜鍍膜製程後,在CMP製程中上層減薄厚度的量測,也有高膜厚精度顯微分光量測儀OPTM可以對應。並使用正反射的方式依膜厚需求選配對應之波長範圍(可從UV紫外光波段到NIR近紅外光波段),完全可以支援針對一般鍍膜工程所需要的膜厚量測範圍10-10000A。
其量測精度誤差在A(0.1nm)等級,單點量測時間可以在一秒內完成。同樣搭配高倍率的光學顯微系統,可以量測spot size光斑依照規格(最小可以縮小到3um),再搭配自動定位Auto alignment的功能,自動定位量測點位到樣品表面任何待測Pattern位置。並依據實際產線需求,給予In-situ 或是 standalone型式做選擇,提供產線自動化SECS/GEM的通訊協定支援。

CMP Slurry的關鍵製程指標有哪些?
評估一款CMP Slurry的整體性能,需從多項關鍵製程指標進行綜合判斷,涵蓋傳統物理參數與後續電性良率相關的評估指標,才能全面掌握其對製程穩定度與晶圓品質的影響:- MRR(Material Removal Rate)材料去除率:去除率需兼顧速度與穩定性。高 MRR 能縮短製程時間,但仍需避免過度侵蝕與損傷底層結構,因此常透過化學與機械參數共同控制。
- WIWNU(Wafer-Intra-Wafer Non-Uniformity)片內均勻性:均勻性是衡量 Slurry 能否於整片晶圓維持穩定研磨的重要指標。WIWNU 越低,後段製程的膜厚一致性越高,可顯著提升整體良率。
- Selectivity(選擇性):針對不同膜層的抑制或加速機制會形成特定的選擇性。例如 Cu 與 Barrier 間的差異控制、Oxide 與 Nitride 間的選擇性等,皆仰賴化學配方的精準調整。
- Defectivity(缺陷率):包含刮痕(Scratch)、腐蝕(Corrosion)、殘留顆粒(Residue)、點缺陷(Pitting)等。缺陷率高會直接影響後段光阻塗佈、曝光、蝕刻及金屬沉積的品質,因此 Defectivity 是先進製程最具敏感度的指標之一。
電性行為相關指標|晶圓表面電位與Zeta Potential
- 電位相關指標:隨著製程微縮與介面敏感度提升,「晶圓表面電位(Wafer Surface Potential)」與「研磨液電位(Zeta Potential)」也成為 CMP 製程中不可忽略的重要參數。這些電性行為會直接影響磨料在晶圓表面的吸附與研磨表現,成為CMP Slurry性能的重要指標。
- 晶圓表面電位:晶圓表面可能因材料特性、化學反應速率、氧化層形成狀態而帶有不同極性的表面電荷,晶圓電位控制通常透過 pH、氧化劑濃度與添加物平衡來達成
| 磨料吸附行為 | 若晶圓表面與磨料帶相反電荷,吸附量增加,去除率可能上升,但亦可能提高刮痕機率 |
| 缺陷生成機制 | 相同電位可能造成磨料排斥,提高顆粒滑移,降低缺陷但可能使 MRR 降低 |
| 腐蝕與侵蝕速度 | 晶圓電位變化會影響化學反應層厚度,進而影響選擇性與均勻性 |
- 研磨液電位 (Zeta Potential):Zeta Potential 為磨料在溶液中的電荷狀態,是 Slurry 分散穩定性的核心指標之一。
| 高絕對值 Zeta Potential |
代表分散穩定、凝聚風險低、顆粒不易黏附晶圓,缺陷率較低 |
| 低絕對值 Zeta Potential(接近 0 mV) |
磨料易聚集,可能形成大型顆粒造成刮痕、不均勻侵蝕或局部過度研磨 |
Zeta Potential也會影響磨料與晶圓表面的靜電吸附行為,因此必須與晶圓電位共同考量,形成CMP界面行為的電性平衡。故先進製程會將Zeta Potential與晶圓電位視為CMP Slurry的「基礎物性項目」,並納入量產監控機制中。
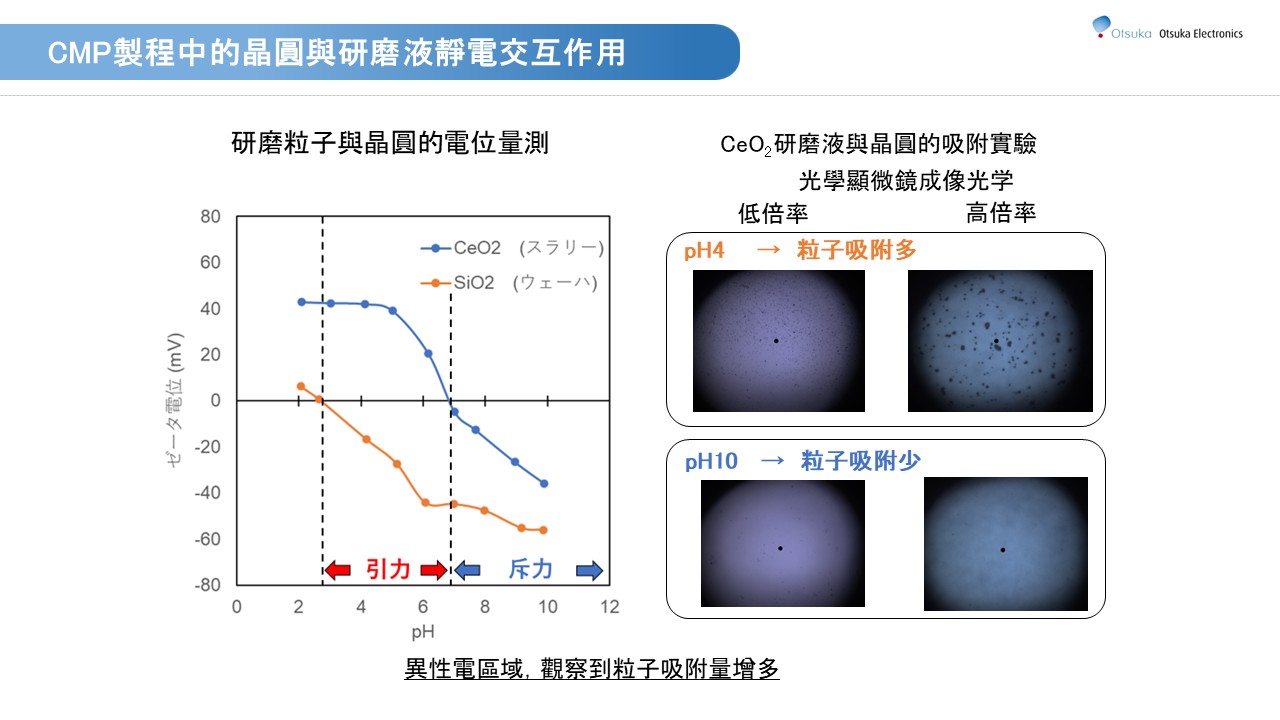

CMP成效的三角關係:Pad × Conditioner × Slurry 的聯動機制
CMP製程的成效不僅取決於Slurry本身,其表現更受到Pad與Conditioner之間的交互作用所影響。此三者形成一組動態平衡,直接關聯到晶圓表面的研磨速率與均勻性。三者角色與功能說明
- Pad:左右接觸壓力、孔洞結構、含液量與磨料保留狀態。
- Conditioner:則透過鑽石刮片開孔,使 pad 維持適當表面粗糙度,避免 glazing(硬化失效。
- Slurry: 決定化學反應速率、磨料切削行為與流體潤滑狀態。
動態調整的實務情境
當其中任一條件偏移時,其餘兩項就需重新調整。常見的例子如下:- Slurry去除率(MRR)提升:若未同步調整Pad的表面粗糙度或孔洞結構,則可能導致局部過度研磨,降低片內均勻性。
- Pad過度開孔:雖能提升Slurry的吸收與流通,但也會加快Slurry消耗速率,甚至提高局部侵蝕風險。
CMP Slurry製程應用與管理推薦
大塚科技長期協助半導體客戶建立CMP製程的量測基礎,並針對Slurry與研磨後表面狀態提供一系列量測解決方案,包括:- 界達電位粒徑分析儀:評估 Slurry 中磨料粒徑、分佈與穩定性。獨家的固體表面電位量測機能更能進一步評估晶圓與研磨液/清潔劑間的電性交互作用。
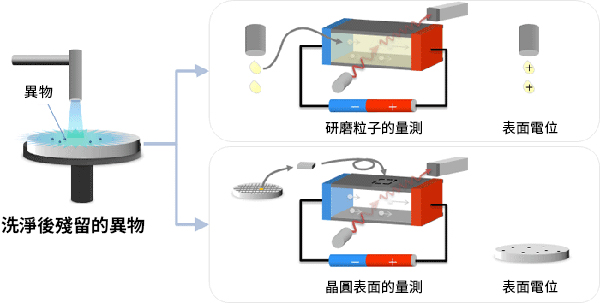
- 分光干涉晶圓厚度儀:以超高速實時量測各階段的研磨,精準監控研磨厚度。
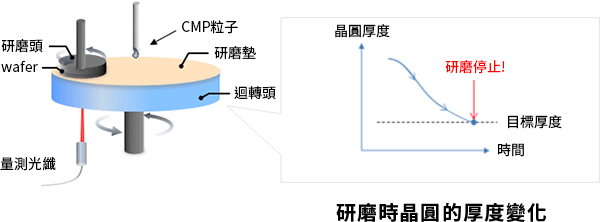
- 光學膜厚量測系統:用於CMP前後膜厚差分析,協助製程監控膜厚均勻性。

透過完整的量測鏈,大塚科技能協助客戶掌握Slurry行為與製程變因,提升 CMP 製程的可靠度與重現性。
成立於1970年的大塚電子,在2003年進入臺灣成立-大塚科技,致力於將本身具備的厚實光學量測技術導入,以「光」為中心研發出各項量測需求,並提供客戶最佳的解決方案。若對於CMP製程還有相關的疑問,不妨就直接到聯絡我們填寫表單,將會有專人為你服務喔!
相關產品
其他相關訊息
-
10.Jul.2025
PVA膜是什麼?4大應用領域要了解,掌握膜厚均勻避免誤差!
-
25.Mar.2025
半導體薄膜製程是什麼?6大技術提升良率,專業應用優勢多!
-
29.Aug.2024
光學膜(Optical Film)是什麼?6大產業應用要知道,推薦機型看這邊!