10Jan.2022
膜厚儀
【光學膜厚量測】多層結構矽晶圓減薄研磨膜厚量測
多層結構矽晶圓減薄研磨膜厚量測
當晶圓進行研磨或蝕刻減薄厚度時,進行即時厚度監控;可於線上確認研磨厚度達到目標值,並停止製程,不須待停止後出片確認,提高製程效率。量測:Si wafer總厚、研磨前後厚度變化
樣品組成:Sapphire 700 μm/Wax 20 μm /Si 700 μm其中Sapphire及Wax層不變,僅研磨背面的Si層由700μm到200 μm
以兩台光學晶圓厚度量測SF-3,上下同時量測總厚
量測方式:
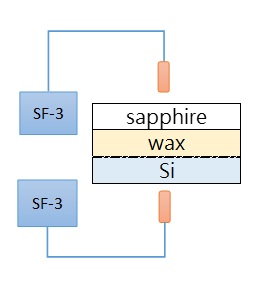
因樣品中間夾RDL金屬層,故無法直接穿透量測;
以上下兩sensor可同時量到總厚及各層厚度
膜厚量測:
第一台SF-3(樣品正面),量測sapphire及Wax厚度
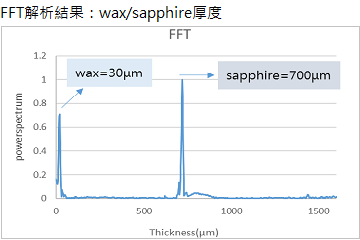
第二台SF-3(樣品背面),量測Si wafer厚度,研磨前700μm、研磨後200μm



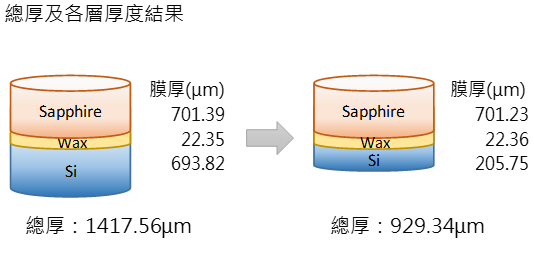
| Sapphire | Wax | Si | 總厚 | |
|---|---|---|---|---|
| 研磨前 | 701.39 | 22.35 | 693.82 | 1417.56 |
| 研磨後 | 701.23 | 22.36 | 205.75 | 929.34 |
以SF-3光干涉式膜厚計可同時量測Si wafer多層膜之個別及總厚度

相關產品
其他相關訊息
-
10.Jul.2025
PVA膜是什麼?4大應用領域要了解,掌握膜厚均勻避免誤差!
-
25.Mar.2025
半導體薄膜製程是什麼?6大技術提升良率,專業應用優勢多!
-
29.Aug.2024
光學膜(Optical Film)是什麼?6大產業應用要知道,推薦機型看這邊!









