MINUK
光波動場3D顯微鏡 MINUK
【高速2秒測量⚡】奈米級非接觸3D量測 ⭕無需逐層對焦・自由觀察任意深度⭕
nm等級的透明異物・缺陷量測評價
不僅只於表面,1次取樣瞬間取得深度方向的情報
無需對焦即可高速量測
非破壞・非接觸・非侵入式量測
輕鬆掃描量測面內任意位置深度
nm等級的透明異物・缺陷量測評價
不僅只於表面,1次取樣瞬間取得深度方向的情報
無需對焦即可高速量測
非破壞・非接觸・非侵入式量測
輕鬆掃描量測面內任意位置深度
量測項目
- nm級非接觸3D顯微成像
產品特色
什麼是3D顯微鏡?3D顯微鏡原理解析
【高速2秒測量⚡】奈米級非接觸3D量測 ⭕無需逐層對焦・自由觀察任意深度⭕
產品特色
- nm等級的透明異物・缺陷量測評價
- 不僅只於表面,1次取樣瞬間取得深度方向的情報
- 無需對焦即可高速量測
- 非破壞・非接觸・非侵入式量測
- 輕鬆掃描量測面內任意位置深度
量測手法
量測時無須對焦,數據取得後可使用軟體任意聚焦於想要觀察的深度表面。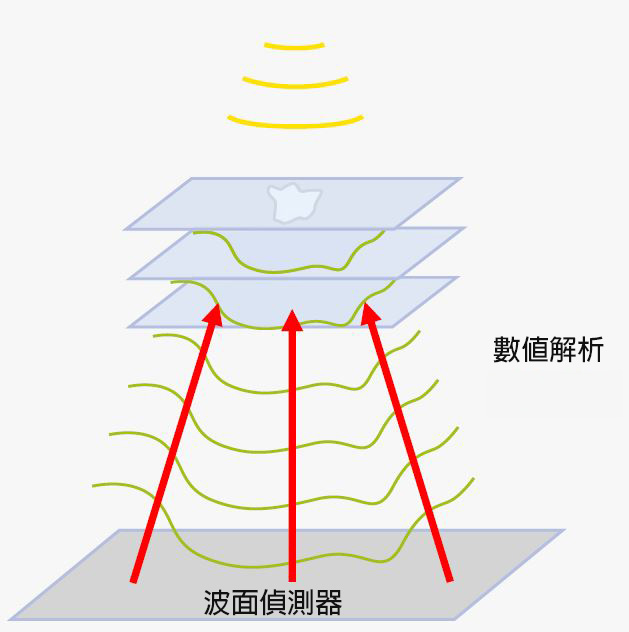

單次量測可取得XY(700×700μm),Z深度 1400 μm的所有資訊。
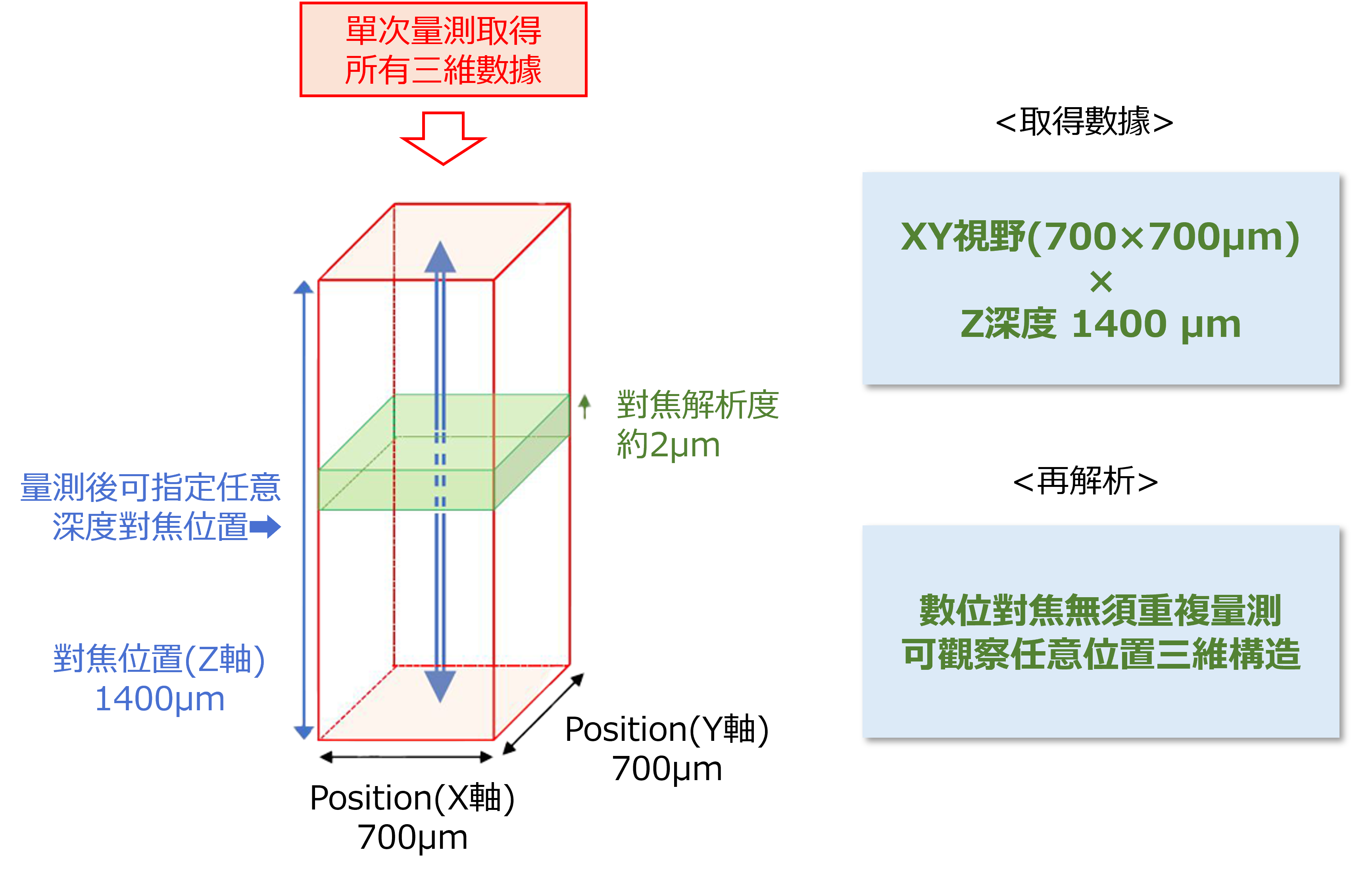
與一般3D顯微鏡比較
一般3D顯微鏡再量測時需要一層一層對焦,光波動場3D顯微鏡 MINUK僅需單次量測(2秒)即可取得所有深度資訊,大幅縮短量測時間。且不會因為傳統顯微鏡因對焦產生周邊區域歪斜等問題。
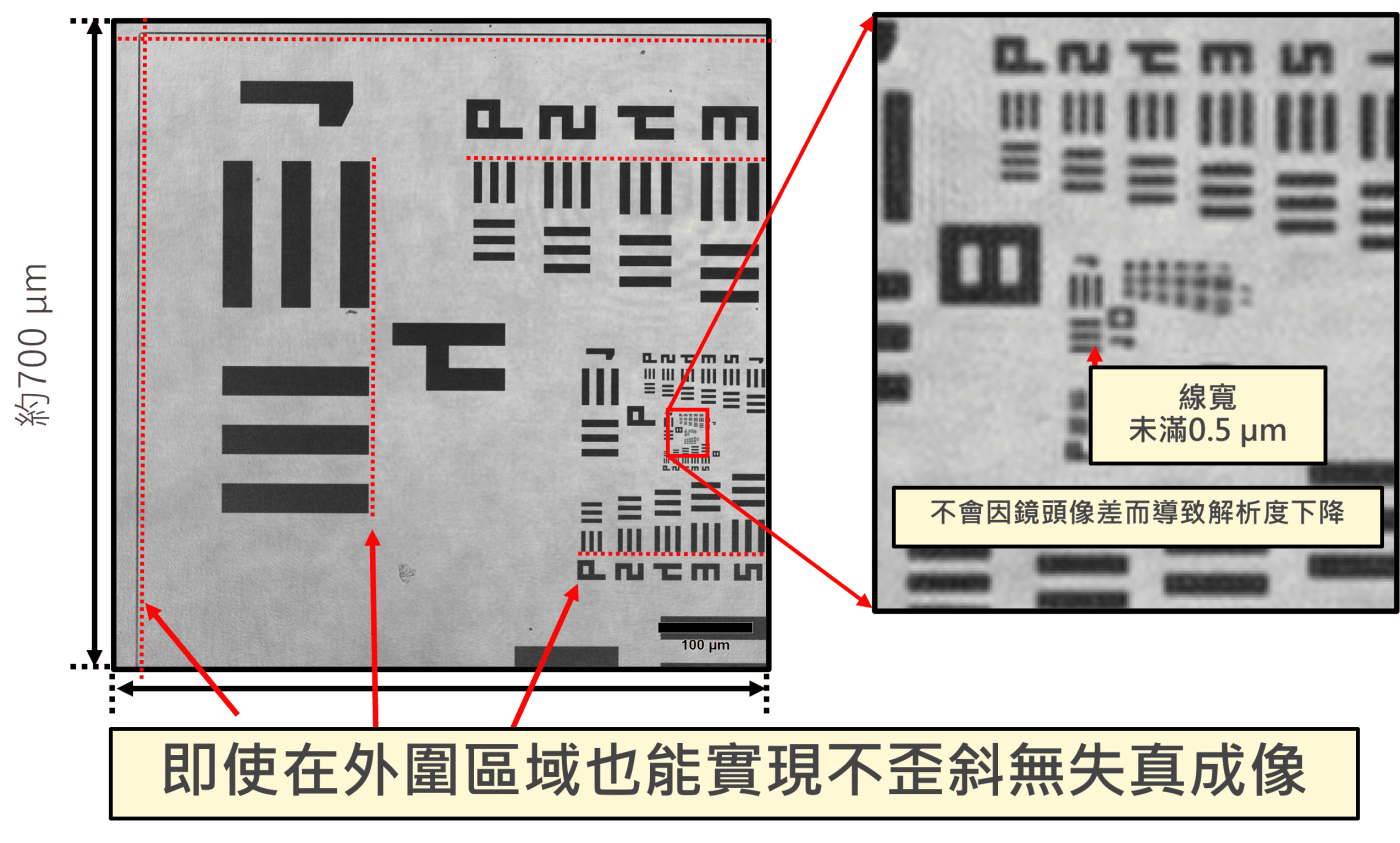
量測範例:TGV開孔量測
光波動場3D顯微鏡 MINUK可在單次量測(2秒)內取得所有3維深度方向的的資訊,並得到孔徑形狀,對位,缺陷Crack等等所有資訊。無須對焦,在單次量測中可以將最高1400μm深度,以最細2μm分割,並得到Z方向的nm級成像。

光波動場3D顯微鏡介紹影片
MINUK是取自日文的「見抜く」(みぬく)讀音,義為一眼看穿事物的真相、看到事物的最深層。以MINUK僅需一次取樣即可快速獲得所有深度方向的情報,「看穿」待測物的所有一切。
規格樣式
| 光波動場3D顯微鏡 MINUK | |
|---|---|
| 解析度 x,y | 691nm(一次取樣)、488nm(合成) |
| 視野 x,y | 700×700μm |
| 解析度 z | 10nm(位相差) |
| 視野 z | ±700μm |
| 樣品尺寸 | 100×80×t20mm(使用泛用載台時) |
| 樣品載台 | 微調XY載台(自動) X:±10mm Y:±10mm 粗調載台 X:129mm Y:85mm |
| 雷射光源 | 波長 638nm 功率 0.39mW 以下 Class1 (量測樣品的照射強度) |
| 機台尺寸 | 機台本體:505(W)×630(D)×439(H) ±20mm ※不含電腦、附屬品 |
| 重量 | 約 41kg |
| 電力 | 機台本體:290VA ※不含電腦、附屬品 |
量測範例
光波動場3D顯微鏡應用場合
將肉眼不可見的透明薄膜表面可視化・定量化
以非接觸・非破壊・非侵入方式取得nm奈米等級的形狀情報。一次取樣即可取得深度方向的所有情報,將肉眼不可見的透明薄膜表面的傷痕、缺陷等橫切面形狀數值化。
觀察透明薄膜內部的填充料
肉眼不可見的透明薄膜內部的填充料,由一次取樣即可觀察。量測後可自由改變深度方項,識別各個深度的填充料。
可視化並量化載玻片表面形成的透明形狀
可以快速視覺化和量化在表面或內部形成的肉眼無法看到的透明結構。圖為黏著劑在載玻片上乾燥狀態,右邊為紅線的橫切面。

即時觀察載玻片上透明形狀的變化
在一次性成像模式下,可以視覺化和量化不斷變化的形狀,例如液體。可以用來評估動態變化的物體並闡明動態現象的機制。
圖為載玻片上甲醇的蒸發現象。

明視野模式下無須染色即可觀察細胞
傳統顯微鏡在觀察細胞等透明物質需要染色,光波動場3D顯微鏡在明視野模式下可以不需染色直接觀察,更能清楚看到細胞核等。
檔案下載
-
大塚科技產品型錄(綜合)
綜合型錄
technical article
技術文章
-
16Sep.2025
三次元量測儀是什麼?3D量測原理、5大技術比較與使用方法解析
在高精密製造領域裡,三次元量測儀已經成為品質控管不可或缺的工具。它透過3D量測技術,能在微米等級的精度下檢驗工件尺寸與幾何特徵,確保產品從設計到量產的每一環節都能符合國際標準。想要替企業建立更嚴謹的檢驗流程?那就先從深入了解三次元量測儀的原理與用途開始吧!
-
25Aug.2025
三維光波動場顯微鏡(3D-OWFM):活細胞觀察的新世代突破
在生命科學與醫學研究中,如何清楚觀察「活細胞」的結構與行為,一直是科研人員的重要課題。傳統顯微鏡(相差顯微鏡、螢光顯微鏡、電子顯微鏡)雖然廣泛應用,但仍有不少限制。三維光波場顯微鏡(3D-OWFM, 3D Optical Wave Field Microscope) 正是為了解決這些問題而誕生的新技術。它利用光的波動特性,透過分析光學路徑差(Optical Path Difference, OPD),能夠即時、無染色、非侵入地觀察活細胞的細微結構。
-
23Jan.2024
矽穿孔(TSV)孔徑底材膜厚量測介紹:深入了解TSV製程及原理,知道製品優勢在那裡
在現今科技快速發展之下,TSV(Through-Silicon Via)技術已成為三維積體電路(3D IC)中不可或缺的一環。然而,當TSV的尺寸與結構也越來越精細,這對其孔徑底材膜厚的量測也提出了新的挑戰。TSV孔徑底材膜厚量測,對於確保TSV製程的品質與可靠性至關重要。如果你對於TSV孔技術還是一知半解的話,不妨就透過本文來了解其技術創新發展吧!
Related Products

















