25Nov.2025
粒徑界達電位
晶圓鍵合中的電漿改質表面 Zeta 電位量測與製程控制
晶圓鍵合製程的關鍵技術
在先進半導體製程中,晶圓鍵合(Wafer Bonding)已成為 SOI、MEMS、3D IC 與 Hybrid Bonding 的關鍵技術。無論是低溫直接接合或複雜的異質材料鍵合,SiO₂ 表面上的 OH 基密度、親水性與表面電荷狀態,始終決定接合界面的化學鍵結強度。
在所有晶圓鍵合技術中:
- SiO₂ 表面 OH 基密度
- 親水性變化
- 表面電荷(Zeta 電位)
然而,傳統接觸角(Contact Angle)量測在親水性極高的 SiO₂ 表面上變化有限,不足以解析製程間的微小差異。
最近的研究表明,表面zeta電位(Surface Zeta Potential)是等離子體活化過程更敏感、更可量化的指標,並且已被證明與化學鍵強度相關。
本篇文章將以文獻研究資料<直接接合のためのプラズマ活性化シリコンウェハの表面ゼータ電位と経時変化>
為基礎,並結合 大塚科技 ELSZneo 的平板表面量測技術,說明如何以表面 zeta 電位作為晶圓鍵合製程的新指標,提升接合品質與穩定性。
資料引用自第17回集積化MEMSシンポジウム發表資料
<Suzuki, Y., Kato, J., Karasumi, Y., Matsumoto, T., Shen, J., and Tanaka, S., “Surface zeta potential and time-dependent changes of plasma-activated silicon wafers for direct bonding,” in Proceedings of the 17th Symposium on Integrated MEMS, Oral presentation, No. 11P2-B-4, 2025.>
文章內容概要
- Plasma 活化後,zeta 電位由 –30 mV 下降至 –50 mV
- 電位越負,表示 OH 基密度越高、界面越親水
表面 Zeta 電位如何反映接合強度?
- Plasma 活化後 SiO₂ 表面電位會變得更負
- Zeta 電位愈負,代表 OH 基密度更高、親水性更強
- 這些表面變化會直接提高 SiO₂–SiO₂ 的 化學接合強度
實驗過程:Zeta 電位與接合行為的關聯
為取得可重複的表面狀態,研究採用:- 4 吋 N 型矽晶圓,表面 1 μm 熱氧化膜
- Plasma 活化使用 EVG810(100 W 20–120 秒)
- 進行O2 or N2 Plasma處理
研究主結論包括:
1. Plasma 時間越長 → Zeta 電位越負
顯示表面 OH 基密度增加、化學鍵結能力上升。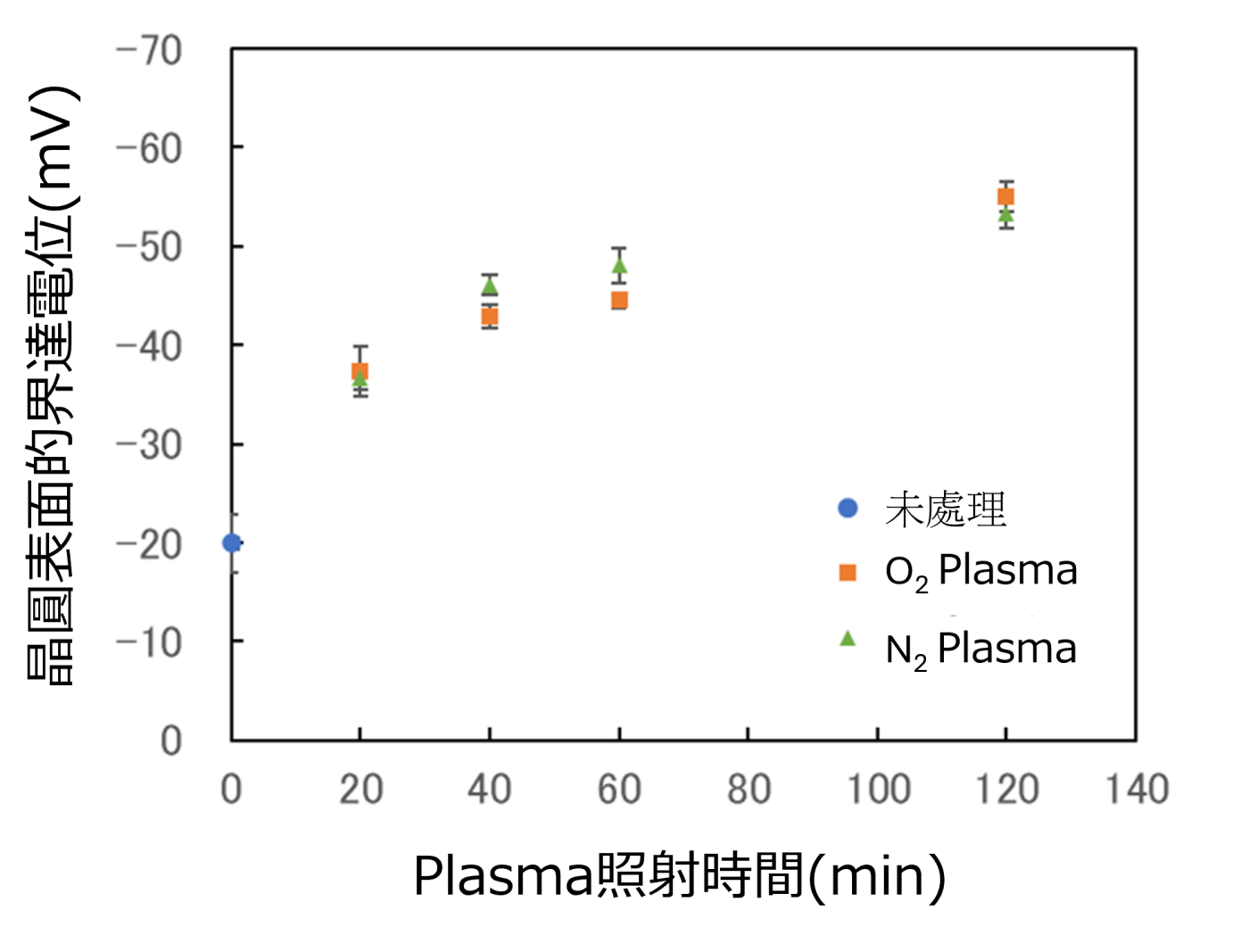
圖.表面zeta電位對Plasma處理時間長短變化
2.與接合界面化學強度具明確相關性
流程概要基板準備:在 4 吋矽晶圓上生長1μm 的熱氧化膜SiO2。
電漿接合:經電漿活化後,在大氣下將兩片 SiO2面直接對接。
退火強化:以 400°C 熱處理,排除介面水分並提升接合強度。
深蝕刻:透過黃光微影與 DRIE 蝕刻單側矽晶圓至氧化層。
氣相釋放:利用氣相 HF 蝕刻接合層的 SiO2,完成最終樣本。
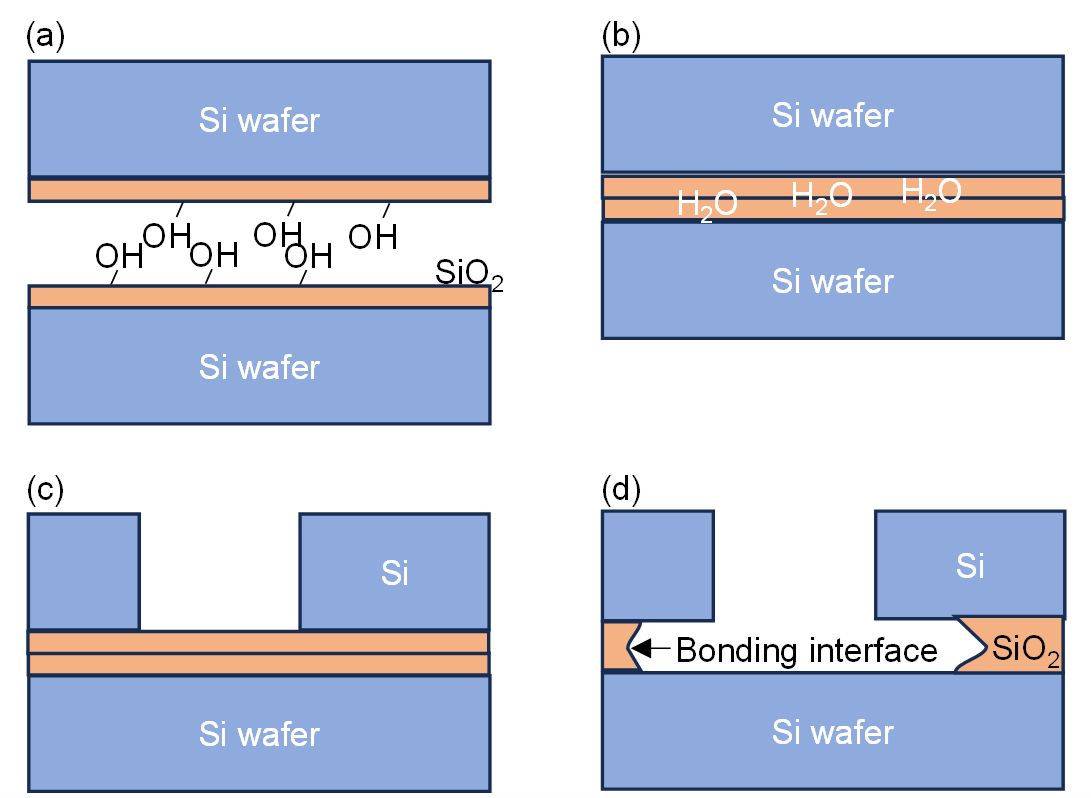
圖.鍵結評估方法
T. Gong, Y. Suzuki, K. Hiller, and S. Tanaka, “Characterization of plasma-activated, thermally-annealed Si-SiO2 direct bond strength for vapor HF etching” Sens. Actuators A: Phys., vol. 363, 114691, 2023.
實驗結果
研究比較兩組不同活化時間(20 sec / 60 sec),其 zeta 電位分別約為:
- 20 sec Plasma(–38 mV) → 蝕刻線條不均、侵蝕距離較大
- 60 sec Plasma(–48 mV) → 蝕刻量較小、界面更均勻
顯示:表面zeta電位與等離子體活化處理時間之間有明顯的關係。
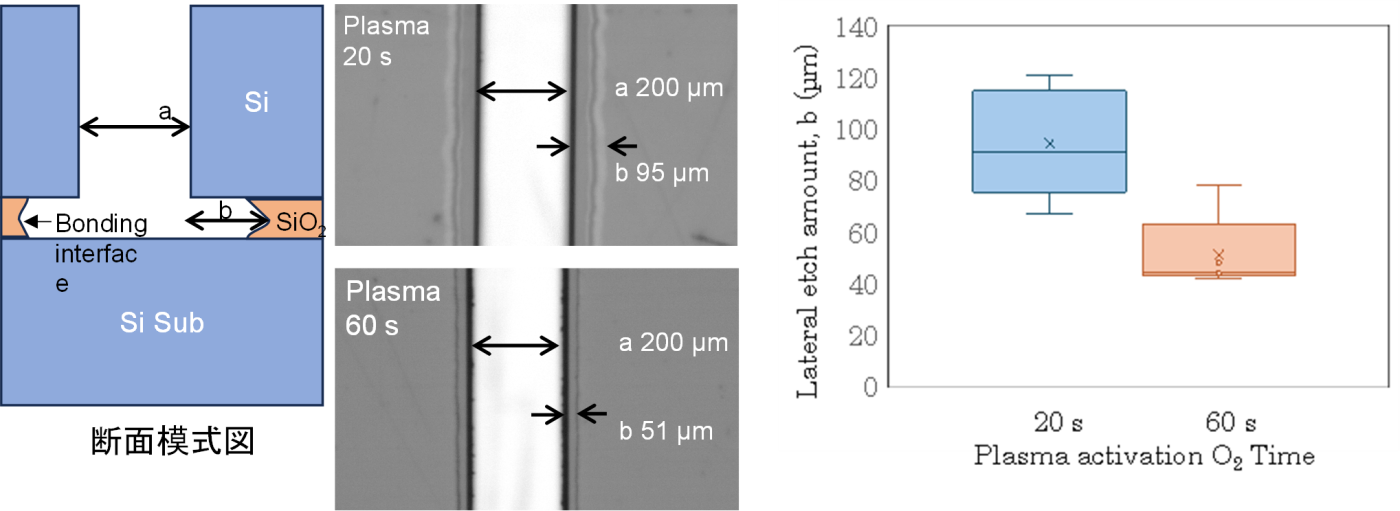
圖.利用紅外線(IR)顯微鏡觀察經由氣相氫氟酸(Vapor HF)蝕刻後的接合界面,藉此定量評估化學接合強度
晶圓改質Zeta 電位量測方法:以電氣滲透流解析表面電荷
研究採用 平板表面 Zeta 電位量測法,其原理為:利用電滲流回推固體樣品帶電符號&大小
實測Cell內數點的電氣泳動,以森・岡本公式實際解析樣品容器內部電氣滲透流狀況→平板狀樣品附近的電滲流圖求得固體表面電位
進一步可以推廣到固體表面電位量測。詳細可以參考本站文章
📖 界達電位量測原理介紹,固態樣品表面電位(surface zeta potential)量測方法與實踐

ELSZneo:為晶圓鍵合製程打造的表面電荷量測解決方案

Zeta 電位已成晶圓鍵合不可或缺的製程指標,研究已明確證實:
- Zeta 電位越負 → 接合化學強度越高
- Plasma 活化品質可用電位變化判定
同場加映:大塚科技 OPTM 與 SF-3 在晶圓鍵合製程中的應用
除了表面Zeta 電位能有效反映 Plasma 活化與接合能力外,晶圓鍵合製程本身也依賴 薄膜結構、晶圓厚度與基板平整度的穩定性。大塚科技的 OPTM 與 SF-3 系列設備,在這些檢測需求中提供高精度、高速且量測範圍廣的解決方案。
1. OPTM:極薄膜量測 × 微小區域解析 × 高速檢測

大塚科技 OPTM 系列為顯微分光式膜厚量測儀,具備:
- 1 nm 起的極薄膜量測能力
- 3 μm 微小聚焦點,適合測量局部區域
- 1 秒內完成單點量測
- 非接觸式光學法、無損分析
- Plasma 活化前後薄膜結構(SiO₂、SiN)變化量追蹤
- CMP、清洗後殘膜厚度確認
- 鍵合界面區域的膜層均勻性檢查
- Hybrid Bonding 中介電層厚度控管
2. SF-3:全晶圓厚度量測 × μs 等級反應速度 × 製程線監控

SF-3 系列為分光干涉式晶圓厚度量測儀,具備:
- 跨越 6–1300 μm(矽換算)的大量測範圍
- 高速 μs 等級取樣率,可整合進研磨或鍵合前後製程設備
- 非接觸片上量測
- 適合量產線的 全自動/連續監控
- 鍵合前晶圓厚度控管
- 研磨(Grinding / Lapping)後厚度精準監測
- 厚度均勻性、與平整性確認
- 鍵合後厚度變動與變形分析
想更加深入了解晶圓鍵合的量測小撇步,歡迎聯繫我們。
【重點整理】
🔍為何接觸角無法有效判斷晶圓接合品質? |
|---|
| →SiO₂ 本身親水,接觸角變化小;Zeta 電位可直接反映表面電荷與 OH 基密度。 |
🔍晶圓表面界達電位越負代表什麼? |
|---|
| →代表親水性提升、表面能增加、化學接合能力更強。 |
🔍Plasma 活化與界達電位的關係是? |
|---|
| →活化時間越長、電位越負。 |
🔍為何界達電位能預測晶圓接合強度? |
|---|
| →表面zeta電位成為等離子體活化過程更靈敏、更可量化的指標,並被認為與化學鍵強度有關。 |
相關產品
其他相關訊息
-
04.Mar.2026
背向散射DLS如何進行高濃度粒徑分析?原液粒徑量測4大案例分享!
-
04.Mar.2026
DLS、SEM電子顯微鏡數值差異大嗎?4大因素告訴你,完整比較看這邊!
-
29.Jan.2026
電泳光散射ELS是什麼?圖解量測原理與Zeta電位方法!











