01Mar.2022
膜厚儀
【入門】透過分光法對膜厚進行解析
薄膜膜厚量測需求 |
若有稍微仔細觀察自己身旁的周遭事物的話,其實也不難發現已有數不清的以薄膜技術為核心的產品存在。
・以CPU、記憶體為首的半導體裝置
・以LCD為首的顯示裝置
・以硬碟碟片、光碟為首的儲存媒介
・加工於鏡頭、顯示裝置表面的抗反射鍍膜
・防水膜等高分子製品的表面改質膜等
關於量測、評價裝置的需求,與上述各種的薄膜製造裝置也一同隨之而來。
薄膜膜厚的量測方法 |
若使用分光光度計的量測方式,操作簡單且可不破壞及非接觸式進行量測,只要有屈折率便可執行高精度的量測,但因屈折率會受成膜條件影響,所以也產生需透過其他方式來量測屈折率的必要性。光有波長的性質,與透過物質相互作用所產生的現象就稱為屈折率,所以透過分光法的薄膜量測與用相同量測手法的屈折率息息相關。也就是說,由於膜的屈折率及吸收係數,是依照材料特有的物性所被決定的關係,從膜厚量測的視點來看的話, 雖然為解析複雜化的原因,但從已知膜的物性的視點來看,卻是非常重要的手段。特別是在半導體材料這塊,因其組成跟不純物的比例相當重要的的關係,也成為讓膜組成變化時或改變成膜條件時的檢測工具。
此外,對分光法附加偏光的解析功能後,因可更詳細的觀察到光與物質的相互作用,所以活用這套原理的分光橢偏儀的高階膜厚量測裝置也已被商品化。此款裝置,不但可高精度量測更薄的膜及自行量測屈折率,也可進行膜的異方性分析。
接下來,將對透過分光法的膜厚解析原理,稍微做詳細的論述。
透過光干涉進行膜厚解析 |
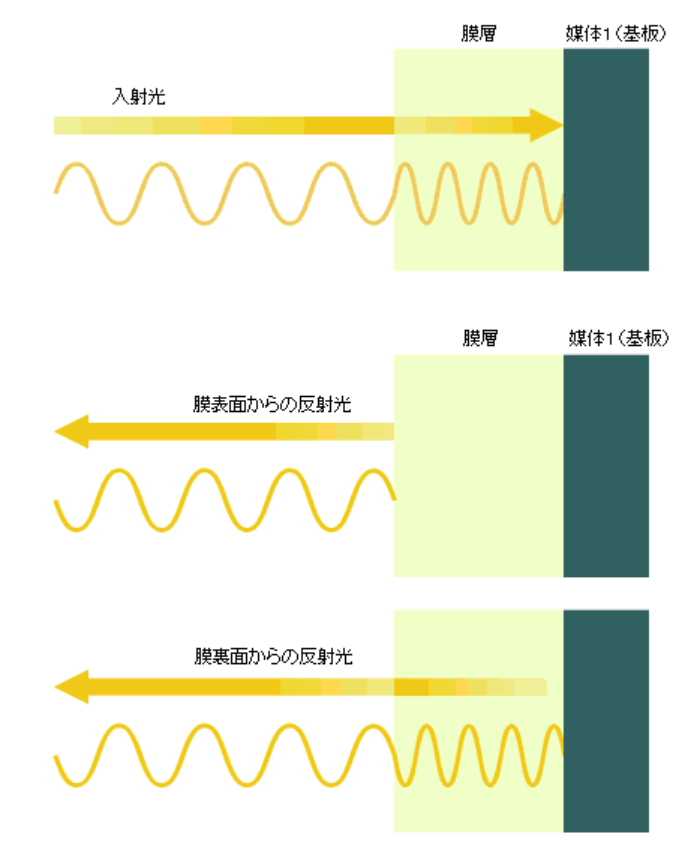
光於通過2次膜層就會被合成的關係,n=屈折率、d=厚度的話,光路差在2nd就會產生.在膜層中光的傳達速度會變n倍慢,所以屈折率就為其重要。最後,反射光的相位會如何變化就成重要關鍵。也就是說,屈折率在大的媒介下反射的位相不會改變,波長的整數倍在光路差2nd的波長就為波峰。相反的,在小的媒介下的反射就會產生180度的分離。也就是空氣/膜/空氣的組合在內部的狀況下,因相位有180度的分離,波長的整數倍在光路差2nd就為波谷。從這關係來看若已知屈折率便可求出厚度。更進一步的,可依照光路差2nd的整數倍的波長是否為波峰或波谷,來判斷出屈折率的大小。
此外,波峰、波谷以外的波長,也可透過curve fitting各波長的反射強度及理論值並計算出膜厚值跟屈折率。
光干涉膜厚理論基礎
經由稜鏡將光散開,可見不同顏色的光,肉眼可見380~780nm為可見光;380以下短波長為紫外光、780nm以上長波長為紅外光。光打到物體表面,會形成一道反射光,若是物體可透光,則會有另一道光進入物體內部。
光進入物體時因折射率的不同,而會產生折射,如筷子插進水裡看似斷掉一般,稱為折射光。
光線進入光纖中,通過狹縫(Slit)後,由光柵(Grating)分光,進入分光器被檢出成為光譜,此光譜可用來做進一步分析。

光干涉
入射光打到透明薄膜,部分由表面反射(R1)、部分透過薄膜後反射(R2),R1與R2因光路差產生相位差β可由下列公式求得
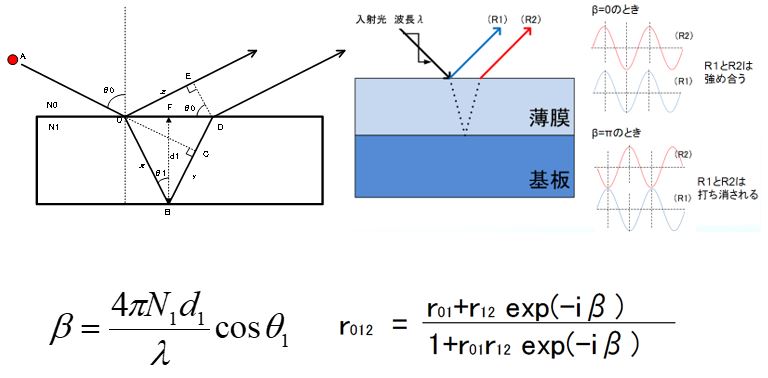
兩束光疊加時即稱為干涉光
此干涉光被光譜儀偵測後,經由計算而得為此物體之反射率
反射率當物體折射率或厚度改變時會隨之變化,因此量測物體之絕對反射率可求出其折射率與厚度等資訊。
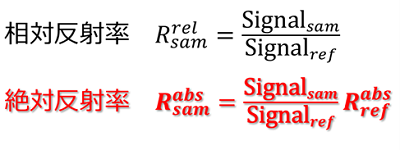
複素曲折率的解析
薄膜的光吸收係數是被作為消衰係數K使用。跟被化學分析所使用的吸光度不同的是,透過將波長相乘,屈折率同樣無次元化。然後,複數屈折率N則是,在電磁波理論的關係式下,使用屈折率n和消衰係數k,就會呈現如同下式被單純化的數式。光在真空中比較,在屈折率n的媒介中則會快速前進,消衰係數變大強度則會衰減。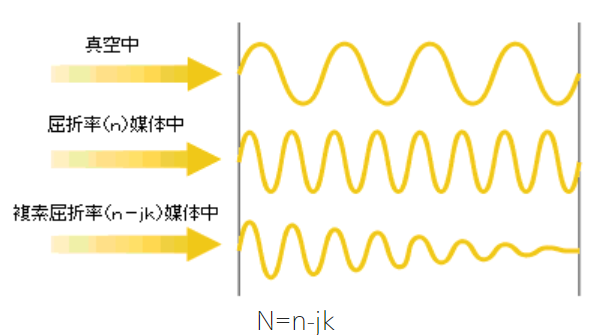
如果只是單純量測膜厚的話,消衰係數的參數會增加並讓解析變得困難,所以普遍都是將近紅外光作為量測光源,來測量沒吸收的波長。液晶用的color filter的話,因著色為品質上的重點要素,所以特別加上透過干涉的著色,讓顯示裝置的色調產生變化的方式也有。然後,在半導體領域方面,為用於顯示結晶內部電子狀態的基準的重要指標,所以對k的量測也變得越來越重要。
再者,絕緣膜會因著色讓裝置性能產生問題, 所以會制定將k值壓低的成膜條件。
若是已知光譜形狀的情況下,便可從反射分光光譜中求出正確的消衰係數K,利用屈折率及消衰係數之間成立的克拉莫-克若尼關係式,就可減少參數。可是,若是在光譜形狀變化的情況下,量測精度沒辦法保證。另外、無法掌握光譜模式的情況下,也無法從反射分光光譜中求出k。
為了可高精度量測到薄膜的消衰係數,需要將已量測到的透過光譜,與分光光譜橢偏儀和反射光譜做結合.這手法雖相當一般,但缺點只能侷限用於透明基板。
矽晶圓的屈折率很常被拿來研究,也存在著許多文獻資料,但文獻所記載的數據,卻也常有相互差異的問題。通常成膜會被用於矽晶圓上的關係,就算是屈折率和消衰係數兩者相異,但依結果來看得到的反射光譜及分光光譜橢偏儀都和理論計算完全一致。近幾年已開始將外延成長的矽膜貼至絕緣基板上,並用於半導體基板,像這樣的矽膜會因光透過的關係,消衰係數的差異會直接反映於光譜。也就是說就算直接沿用文獻值也無法高精度的解析光譜,反而會與文獻值產生出入。上述也就是文獻值有相當誤差的例子。
橢圓偏光法量測膜厚 |
單一波長的橢偏儀,從就是將膜厚值從tanψ或者△等等的橢偏儀參數中單純計算,但因為多層膜的話,model式會變得太過複雜而無法簡單計算。這時候,透過讓波長變化,執行曲線擬合、多變量分析,多膜層的解析也會變的可行,近幾年也隨著電腦的進步讓解析時間大幅縮短,所以此做法也被廣泛使用。
橢偏儀有橢圓的含意在。因光為波的關係,直行方向的偏光相位若有90度的分離就成圓偏光.就如同下圖所表示,從光的進行方向來看偏光的方向的話,時間會一同左迴轉。相位偏離在90度以外就會形成橢圓。偏光的解析就是為了分析此橢圓偏光而被稱為橢圓偏振技術。光有波長的性質,也就是說, 活用強度、相位和波長這三個資訊就為分光橢圓偏振技術。

為什麼分析橢圓偏光就可以求出膜厚?P波指的是在反射面法線上用平行偏光、S波則指的是法線用直角偏光的成分名稱。膜厚量測的話,分光橢偏儀的量測都是用有一定的入射角的反射量測來執行。P波和S波在表面加上反射率的差異、反射率的比會透過光干渉產生効果,成為tan。然後在薄膜的媒介中因光的行進速度有差異,會產生相位差.加上這部分,因反射時P波及S波的相位變化差異,兩者就會產生相位差。因此相位差也會依膜厚有所變化.這就是透過分光偏橢儀的膜厚量測原理。
橢偏儀的原理說明不依靠算式的話會有相當難度,Azamus所寫的電磁氣學的說明最容易理解。也就是說這套原理用算式進行下最為正確及讓人容易理解,而在沒使用算式的情況下,用光譜的形狀來說明會僅次於算式來得容易理解。
透過分光橢偏儀的屈折率及膜厚量測,雖為高感度的方法,膜厚較厚的話,只要n有稍微不同就可於光譜上觀察到變化。利用此特性於膜界面的狀態、膜的縦方向的密度勾配等的議論雖然也為數眾多,但用這樣的詳細解析,多少會有些風險存在。因為能讓光譜變化的因素有很多,特別是對膜表面的狀態影響甚大,會有不知道哪個才是膜的model的問題發生。
分光橢偏儀法的計算也是有極限。若是膜為數nm程度的薄膜情況下,會變成光波長的百分之一程度,雖然可以求出nd.但會無法將兩者分開。此缺點也是分光法的共同問題點。
光學膜厚構造分析方法 |
舉例來說,高速進行的省電SOI(用Si將SiO2包覆的結構)的情況,表層的Si跟中央的SiO2層的兩者厚度會影響品質,但使用分光法就能對像這種多層構造進行各層的膜厚量測.
然後,被退火處理的ITO(透明導電膜)雖然透明性及導電性會提升,但受熱的表面及難以熱傳導的基板面會慢慢產生膜質變化。
而針對類似這樣膜質厚度的階段變化的解析也是可行的。
其他像液晶會因方向導致屈折率不同的材料的三次元屈折率解析、面積內的膜厚不均一性的解析都是可能的。
敝司也明白對各種領域來說這類的構造解析是非常重要,所以對相關的開發也持續投入許多資源。
大塚的光學膜厚量測陣容
敝司為了解決客戶對薄膜到厚膜之間的廣泛膜厚量測需求,現行已提供可利用紫外、可視、紅外光量測1nm到10mm的產品陣容。最後,關於針對解析的演算法,為了能提供客戶最先端的技術,也在不斷進行開發改良中。
若有想進一步了解的地方,歡迎隨時與我們聯繫。
相關產品
其他相關訊息
-
10.Jul.2025
PVA膜是什麼?4大應用領域要了解,掌握膜厚均勻避免誤差!
-
25.Mar.2025
半導體薄膜製程是什麼?6大技術提升良率,專業應用優勢多!
-
29.Aug.2024
光學膜(Optical Film)是什麼?6大產業應用要知道,推薦機型看這邊!











